传统的PCB板的钻孔由于受到钻刀影响,当钻孔孔径达到0.15mm时,成本已经非常高,且很难再次改进。而HDI板的钻孔不再依赖于传统的机械钻孔,而是利用激光钻孔技术。(所以有时又被称为镭射板。)HDI板的钻孔孔径一般为3-5mil(0.076-0.127mm),线路宽度一般为3-4mil(0.076-0.10mm),焊盘的尺寸可以大幅度的减小所以单位面积内可以得到更多的线路分布,高密度互连由此而来。
HDI技术的出现,适应并推进了PCB行业的发展。使得在HDI板内可以排列上更加密集的BGA、QFP等。目前HDI技术已经得到广泛地运用,其中1阶的HDI已经广泛运用于拥有0.5PITCH的BGA的PCB制作中。
HDI技术的发展推动着芯片技术的发展,芯片技术的发展也反过来推动HDI技术的提高与进步。
目前0.5PITCH的BGA芯片已经逐渐被设计工程师们所大量采用,BGA的焊角也由中心挖空的形式或中心接地的形式逐渐变为中心有信号输入输出需要走线的形式。
所以现在1阶的HDI已经无法完全满足设计人员的需要,因此2阶的HDI开始成为研发工程师和PCB制板厂共同关注的目标。1阶的HDI技术是指激光盲孔仅仅连通表层及与其相邻的次层的成孔技术,2阶的HDI技术是在1阶的HDI技术上的提高,它包含激光盲孔直接由表层钻到第三层,和表层钻到第二层再由第二层钻到第三层两种形式,其难度远远大于1阶的HDI技术。
二.材料:
1、材料的分类
a.铜箔:导电图形构成的基本材料
b.芯板(CORE):线路板的骨架,双面覆铜的板子,即可用于内层制作的双面板。
c.半固化片(Prepreg):多层板制作不可缺少的材料,芯板与芯板之间的粘合剂,同时起到绝缘的作用。
d.阻焊油墨:对板子起到防焊、绝缘、防腐蚀等作用。
e.字符油墨:标示作用。
f.表面处理材料:包括铅锡合金、镍金合金、银、OSP等等。
2、层压的绝缘层材料
2.1 SYE 使用的板材一览表

2.2、HDI 绝缘层材料
2.2.1 SYE HDI绝缘材料一览表

2.3 特殊材料的介绍:
HDI绝缘层所使用的特殊材料 RCC :
涂胶膜铜箔(Resin Coated Copper)
涂胶膜铜箔(Resin Coated Copper) 是指将特别的树脂膜层涂在电镀铜箔上。这层膜可以完全覆盖内层线路而成绝缘层.
主要有两种: B stage (Mitsui)和 B+C stage(Polyclad)
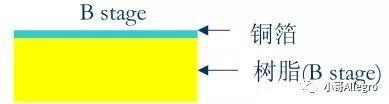

特点:
*不含玻璃介质层,易于镭射以及等离子微孔成形.
*薄介电层.
*极高的抗剥离强度.
*高韧性,容易操作.
*表面光滑,适合微窄线路蚀刻.
涂胶膜铜箔(Resin Coated Copper): 一般来说,HDI 板 的激光钻孔都是在涂胶膜铜箔上面成孔。孔径的形状与一般机械钻孔的孔的形状不完全一样。激光钻孔的孔的形状为一个倒置的梯形。而一般的机械钻孔,孔的形状为柱形。考虑到激光钻孔的能量与效率,镭射孔的孔径大小不能太大。一般为0.076-0.10毫米。

HDI板所需要的其他的材料如:板料;半固化片和铜箔等则没有特别的要求。由于镭射板的电流一般不会太大,所以线路的铜的厚度一般不太厚。内层一般为1盎司,外层一般为半盎司的底铜镀到1盎司的完成铜厚 。板料的厚度一般较薄。并且由于RCC中也仅含树脂,不含玻璃纤维,所以使用RCC的HDI板的硬度/强度一般比同厚度的其他PCB要差。
2.4 目前HDI板的一般结构:
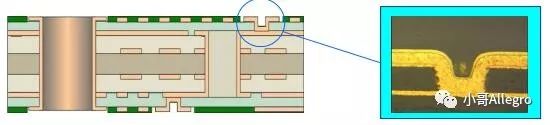
1-HDI
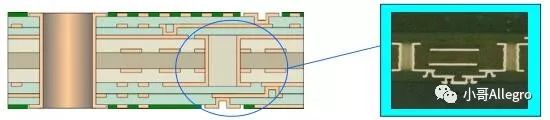
Non stacked 2-HDI
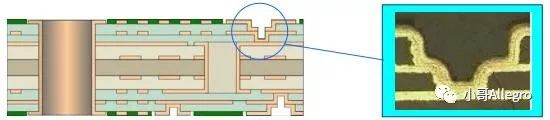
Stacked But Non Copper filled 2-HDI
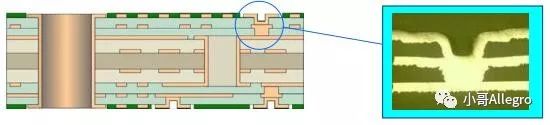
Stacked & Copper filled 2-HDI
2.5 不同HDI绝缘层材料的效果
这些是不同类型的一阶盲孔切片图(A)
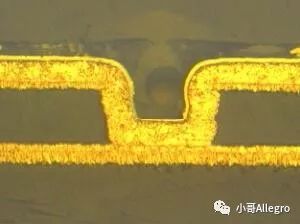
RCC

FR4(1080)
这些是二阶HDI 盲孔的切片图
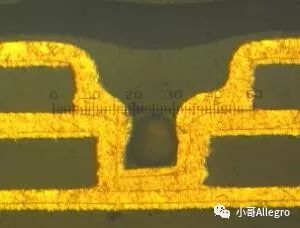
RCC

FR4
三.流程:
下面我们将以一个2+4+2的8层板为例来说明一下HDI的制作流程:
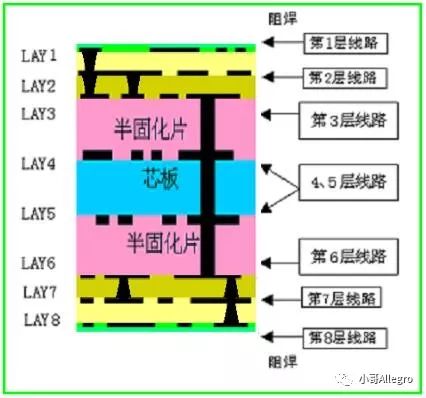
1.开料(CUT)
开料是把原始的敷铜板切割成能在生产线上制作的板子的过程。
首先我们来了解几个概念:
1. UNIT:UNIT是指客户设计的单元图形。
2. SET :SET是指客户为了提高效率、方便生产等原因,将多个UNIT 拼在一起成为的一个整体图形。它包括单元图形、工艺边等等。
3. PANEL:PANEL是指PCB厂家生产时,为了提高效率、方便生产等原因,将多个SET拼在一起并加上工具板边,组成的一块板子。我们采购回来的大料有以下几种尺寸:36.5 INCH × 48.5 INCH、40.5 INCH × 48.5 INCH 、42.5 INCH × 48.5 INCH 等等。 作为PCB设计的工程师与设计的工程师与PCB 制作的工程师,利用率是大家共同关注的问题。
2.内层干膜:(INNER DRY FILM)
内层干膜是将内层线路图形转移到PCB板上的过程。
在PCB制作中我们会提到 图形转移这个概念,因为导电图形的制作是PCB制作的根本。所以图形转移过程对PCB制作来说,有非常重要的意义。
内层干膜包括内层贴膜、曝光显影、内层蚀刻等多道工序。内层贴膜就是在铜板表面贴上一层特殊的感光膜。这种膜遇光会固化,在板子上形成一道保护膜。曝光显影是将贴好膜的板将进行曝光,透光的部分被固化,没透光的部分还是干膜。然后经过显影,褪掉没固化的干膜,将贴有固化保护膜的板进行蚀刻。再经过退膜处理,这时内层的线路图形就被转移到板子上了。
对于设计人员来说,我们最主要考虑的是布线的最小线宽、间距的控制及布线的均匀性。因为间距过小会造成夹膜,膜无法褪尽造成短路。线宽太小,膜的附着力不足,造成线路开路。所以电路设计时的安全间距(包括线与线、线与焊盘、焊盘与焊盘、线与铜面等),都必须考虑生产时的安全间距。
3.黑化和棕化:(BLACK OXIDATION)
黑化和棕化的目的
1. 去除表面的油污,杂质等污染物;
2. 增大铜箔的比表面,从而增大与树脂接触面积,有利于树脂充分扩散,形成较大的结合力;
3. 使非极性的铜表面变成带极性CuO和Cu 2 O的表面,增加铜箔与树脂间的极性键结合;
4. 经氧化的表面在高温下不受湿气的影响,减少铜箔与树脂分层的几率。内层线路做好的板子必须要经过黑化或棕化后才能进行层压。它是对内层板子的线路铜表面进行氧化处理。一般生成的Cu 2 O为红色、CuO为黑色,所以氧化层中Cu 2 O为主称为棕化、CuO为主的称为黑化。
4.层压:(PRESSING)
1. 层压是借助于B—阶半固化片把各层线路粘结成整体的过程。这种粘结是通过界面上大分子之间的相互扩散,渗透,进而产生相互交织而实现。
2. 目的:将离散的多层板与黏结片一起压制成所需要的层数和厚度的多层板。
排版
将铜箔,黏结片(半固化片),内层板,不锈钢,隔离板,牛皮纸,外层钢板等材料按工艺要求叠合。如果六层以上的板还需要预排版。
层压过程
将叠好的电路板送入真空热压机。利用机械所提供的热能,将树脂片内的树脂熔融,借以粘合基板并填充空隙。
对于设计人员来说,层压首先需要考虑的是对称性。因为板子在层压的过程中会受到压力和温度的影响,在层压完成后板子内还会有应力存在。因此如果层压的板子两面不均匀,那两面的应力就不一样,造成板子向一面弯曲,大大影响PCB的性能。
另外,就算在同一平面,如果布铜分布不均匀时,会造成各点的树脂流动速度不一样,这样布铜少的地方厚度就会稍薄一些,而布铜多的地方厚度就会稍厚一些。为了避免这些问题,在设计时对布铜的均匀性、叠层的对称性、盲埋孔的设计布置等等各方面的因数都必须进行详细考率。
5.钻盲埋孔:(DRILLING)
印制板上孔的加工形成有多种方式,目前使用最多的是机械钻孔。机械钻孔就是利用钻刀高速切割的方式,在板子(母板或子板)上形成上下 贯通的穿孔。对于成品孔径在8MIL及以上的穿孔,我们都可以采用机械钻孔的形式来加工。
目前来说,机械孔的孔径必须在8mil以上。机械钻孔的形式决定了盲埋孔的非交叉性。就以我们这块八层板而言,我们可以同时加工3 — 6层的埋孔、1—2层的盲孔和7 — 8层的盲孔等等形式。但如果设计的是既有3-5层的埋孔,又有4-6层的埋孔,这样的设计在生产上将无法实现。另外,从前面的层压我们可以了解到对称的必要性,如果此时不是3-6层的埋孔而是3-5层或4-6层的埋孔,制作难度与报废率将大幅提高,其成本将是3-6层埋孔的6倍以上。
6.沉铜与加厚铜(孔的金属化)
? 电路板的基材是由铜箔,玻璃纤维,环氧树脂组成。在制作过程中基材钻孔后孔壁截面就是由以上三部分材料组成。电路板的基材是由铜箔,玻璃纤维,环氧树脂组成。在制作过程中基材钻孔后孔壁截面就是由以上三部分材料组成。
? 孔金属化就是要解决在截面上覆盖一层均匀的,耐热冲击的金属铜。孔金属化就是要解决在截面上覆盖一层均匀的,耐热冲击的金属铜。
? 流程分为三个部分:一去钻污流程,二化学沉铜流程,三加厚铜流程(全板电镀铜)。
孔的金属化涉及到一个制成能力的概念,厚径比。厚径比是指板厚与孔径的比值。
当板子不断变厚,而孔径不断减小时,化学药水越来越难进入钻孔的深处,虽然电镀设备利用振动、加压等等方法让药水得以进入钻孔中心,可是浓度差造成的中心镀层偏薄仍然无法避免。这时会出现钻孔层微开路现象,当电压加大、板子在各种恶劣情况下受冲击时,缺陷完全暴露,造成板子的线路断路,无法完成指定的工作。
所以,设计人员需要及时的了解制板厂家的工艺能力,否则设计出来的PCB就很难在生产上实现。需要注意的是,厚径比这个参数不仅在通孔设计时必须考虑,在盲埋孔设计时也需要考虑。
7.第二次内层干膜
当3--6层的埋孔金属化后,我们用树脂油墨塞孔,然后我们的板子将转回到内层干膜制作第3、6层的内层线路。如下图:
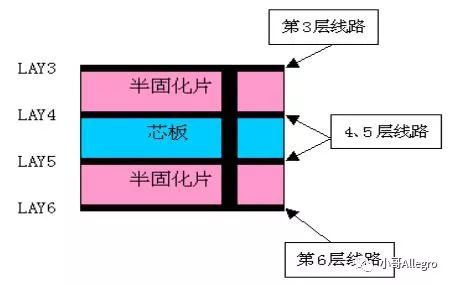
做完3、6层的线路后,我们将板子进行黑化或棕化,之后我们将其送入第二次层压。由于与前面步骤相同,就不再详细介绍。
8.第二次层压(HDI的压板)
HDI板的压板:由于HDI的绝缘层厚度比较薄。所以压板较为困难。由于同样的厚度LDP的强度要比RCC的好很多,流动速度也慢一些,所以也更容易控制。
内层有盲埋孔的地方线路更容易因凹陷而造成开路。所以如果内层如果有盲埋孔,则外层的线路设计要尽量避开内层的盲埋孔位置。至少是线路不要从盲埋孔的孔中间位置通过。
另外如果是在压板时的第二层到倒数第二层之间有太多埋孔的话,压板的过程中将会由于产生了一个通道而导致了位于上面的介电层厚度薄于位于下面的介电层厚度。所以在线路设计时要尽量减少此种孔的数量。
CO 2 激光盲孔制造的工艺很多,而且各有优缺点。而开铜窗法(Conformal mask)是现在业界最成熟的CO 2 激光盲孔制作工艺,此加工法是利用图形转移工艺,在表面铜箔层蚀刻出线路的方式蚀刻出与要激光加工的孔径尺寸相同的微小窗口,然后用比要加工孔径尺寸大的激光光束根据蚀铜底片的坐标程式来进行加工的方法,这种加工法多用于减成法制造积层多层板的工艺上,SYE即是采用了此种工艺进行CO 2 激光盲孔的制作。

9.conformal mask
1.Conformal mask 是打激光孔制作的前准备过程,它分为Conformal mask1 和 Conformal mask2 两个部分。
2.Conformal mask1是在子板上下两面铜箔上用制作线路的方式蚀刻出母板外层周边与子板外层的盲孔(激光孔)对位PAD对应的铜箔,同时蚀刻出母板上对应于设置在子板两面的自动曝光机对位标靶位置铜箔,以供Conformal mask2制作和激光钻孔时使用。
3.Conformal mask2是在板子上下两面铜箔上用制作线路的方式将每个激光孔的位置蚀刻出一个比激光孔稍大的窗口,以供CO 2 激光加工。
10.激光钻孔 (LASER DRILLING)
用激光将树脂烧开形成连通性盲孔HDI板的镭射钻孔由于是由激光钻出,所以当激光在从上往下钻的过程中,能量逐渐变少,所以随着孔径的不断深入,孔的直径不断变小。镭射孔的钻孔孔径一般为4-6mil(0.10-0.15mm),按照IPC6016,孔径<=0.15毫米的孔称为微孔(micro-via)。
如果孔径大于0.15毫米,则难于一次将孔钻完,而是需要螺旋式钻孔,导致了钻孔的效率下降。成本的急剧升高。目前激光钻孔一般采用三枪成孔的方式,镭射孔的钻孔速度一般为100-200个/秒。并且随着孔径的缩小,钻孔的速度明显加快。
比如:在钻孔孔径为0.100毫米时,钻孔速度为120个/秒。在钻孔孔径为0.076毫米时,钻孔速度为170个/秒。
11.激光钻孔的金属化
HDI 板的镭射钻孔由于是由激光钻出,激光钻孔时的高温将孔壁灼烧。产生焦渣附着在孔壁,同时由于激光的高温灼烧,将导致第二层铜被氧化。所以钻孔完毕后,微孔需要在电镀前进行前处理。由于板的微孔孔径比较小,又不是通孔,所以孔内的焦渣比较难以清除。去孔污时需要用高压水冲洗。
对于Stacked形式的2阶HDI,需要专门的盲孔电镀和COPPER FILLING的技术,因此成本上会大大提高,所以目前只用于一些高端产品的设计制作。
12.第三次内层干膜
经过金属化盲孔后,将进行第二次Conformal mask1。然后将开始次外层图形的制作,也就是再次回到内层干膜工序进行2、7层图形制作。制作好的线路会送到黑化工序进行氧化处理。随后PCB会进行第三次层压。
层压后的板子会进行第三次盲孔蚀铜1和第二次盲孔蚀铜2的制作。这是为了第二次激光钻孔做准备。由上可以看到为了第二次HDI需要经过多次的对位,所以对位误差也累积增大,这是造成2阶HDI报废率较大的原因之一。
目前就制作难度来说,对于2阶的HDI板的各种设计,由简至难的顺序如下:
1.有1-2层、2-3层孔。2.仅有1-3层的孔。3.有1-2层、1-3层的孔。4.有2-3层、1-3层的孔。5.有1-2层、2-3层、1-3层的孔。
注:
1.HDI孔设计时需要尽量采用对称设计,以上仅列出一边的情况,另一边也相同。
2.上面指的孔均为HDI孔
13.第二次激光钻孔
14.机械钻孔(钻通孔)
15.去钻污与沉铜(P.T.H)
将盲孔与通孔一起金属化
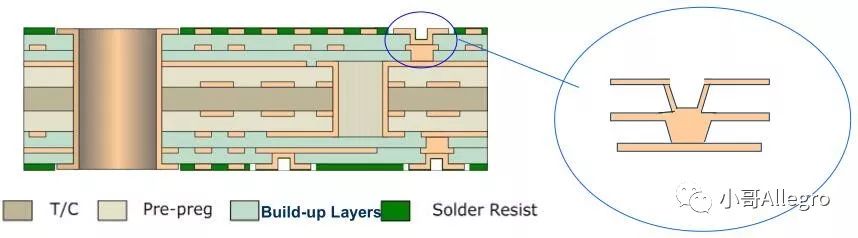
至此HDI的特殊流程结束下面转入普通板的正常流程。
16.外层干膜与图形电镀(DRY FILM & PATTERN PLATING)
外层图形转移与内层图形转移的原理差不多,都是运用感光的干膜和拍照的方法将线路图形印到板子上。
外层干膜与内层干膜不同在于:
⒈ 如果采用减成法,那么外层干膜与内层干膜相同,采用负片做板。板子上被固化的干膜部分为线路。去掉没固化的膜,经过酸性蚀刻后退膜,线路图形因为被膜保护而留在板上。
⒉ 如果采用正常法,那么外层干膜采用正片做板。板子上被固化的部分为非线路区(基材区)。去掉没固化的膜后进行图形电镀。有膜处无法电镀,而没有膜处,先镀上铜后镀上锡。退膜后进行碱性蚀刻,最后再退锡。线路图形因为被锡的保护而留在板上。
17.湿菲林(阻焊) WET FILM SOLDER MASK
1. 概念:阻焊工序是在板子的表面增加一层阻焊层。这层阻焊层称为阻焊剂(Solder Mask)或称阻焊油墨,俗称绿油。其作用主要是防止导体线路等不应有的上锡,防止线路之间因潮气、化学品等原因引起的短路,生产和装配过程中不良操作造成的断路、绝缘以及抵抗各种恶劣环境,保证印制板的功能等。
2. 原理:目前PCB厂家使用的这层油墨基本上都采用液态感光油墨。其制作原理与线路图形转移有部分的相似。它同样是利用菲林遮挡曝光,将阻焊图形转移到PCB表面。其具体流程如下:
前处理—— >涂覆—— >预烘—— >曝光—— >显影——>UV固化—— >热固化
与此工序相关联的是soldmask文件,其涉及到的工艺能力包含了阻焊对位精度、绿油桥的大小、过孔的制作方式、阻焊的厚度等等参数。同时阻焊油墨的质量还会对后期的表面处理、SMT贴装、保存及使用寿命带来很大的影响。加上其整个工序制作时间长、制作方式多,所以是PCB生产的一个重要工序。
目前过孔的设计与制作方式是众多设计工程师比较关心的问题。而阻焊带来的表观问题则是PCB质检工程师重点检查的项目。
18.选择性沉金(IMMERSION GOLD)
化学镀镍/金是在印制电路板做上阻焊膜后,对裸露出来需要镀金属的部分采用的一种表面处理方式。由于科技的发展,PCB上的线宽间距变小,表面封装增多,这就要求连接盘或焊垫有良好的共面性和平坦度,要求PCB不能弯曲。化学Ni/Au表面镀层则可满足上述的要求,另外由于它表层的金比较稳定、防护性好,所以它的存储时间也和铅锡差不多。
由于这种镍/金的镀层是在印制电路板做上阻焊膜后制作的,所以只能采用化学镍/金的方式来实现选择性涂覆。作为PCB的表面镀层,镍层厚度一般为5μm,而金厚一般在0.05—0.1μm之间,作为非可镀焊层Au的厚度不能太高,否则会产生脆性和焊点不牢的故障,如果太薄则防护性不好。其缺点是可焊性较差,容易发生黑盘的缺陷。
19.字符(C/M PRINTING )
20.铣外形(PROFILING)
到目前为止,我们制作的PCB一直都属于PANEL的形式,即一块大板。现在因为整个板子的制作已经完成,我们需要将交货图形按照(UNIT交货或SET交货)从大板上分离下来。这时我们将利用数控机床按照事先编好的程序,进行加工。外形边、条形铣槽,都将在这一步完成。如有V-CUT,还需增加V-CUT工艺。在此工序涉及到的能力参数有外形公差、倒角尺寸、内角尺寸等等。设计时还需考虑图形到板边的安全距离等参数。
21.电子测试(E-TEST)
电子测试即PCB的电气性能测试,通常又称为PCB的“通”、“断”测试。在PCB厂家使用的电气测试方式中,最常用的是针床测试和飞针测试两种。
㈠针床分为通用网络针床和专用针床两类。通用针床可以用于测量不同网络结构的PCB,但是其设备价钱相对较为昂贵。而专用针床是采用为某款PCB专门制定的针床,它仅适用于相应的该款PCB。
㈡飞针测试使用的是飞针测试机,它通过两面的移动探针(多对)分别测试每个网络的导通情况。由于探针可以自由移动,所以飞针测试也属于通用类测试。
22.OSP
有机可焊性保护剂(OSP),又称为防氧化助焊剂、Entek。这种方法是PCB完成所有制作工艺,并经过电测试及初次表观的检验后,经OSP处理后在裸铜焊盘和通孔内而得到一种耐热型的有机可焊性膜。这种有机耐热可焊性膜厚度为0.3~0.5μm之间,分解温度可以达到300℃左右。
OSP技术由于其具有高的热稳定性、致密性、疏水性等许多优点因而迅速得到推广运用。
其主要优点还有:
1.能够克服线宽间距小的问题,其镀层表面很平坦。
2.工艺简单,操作方便,污染少,易于操作、维护和自动化。
3.成本低廉,可焊性好。
其缺点是保护膜极薄,容易划伤,因此在生产和运输过程中要十分小心。另外其可焊性仅仅依靠该层保护膜,一旦膜被损害可焊性就大大降低了。因此它放置的时间也很短。
目前ENIG+OSP已经广泛运用于高精密线路板的设计制作中。用ENIG良好的保护性加上OSP良好的可焊性是无铅化生产替代HSAL的一种解决办法。但由于两种方式的混合运用造成成本较高。
23.最终检查(FINAL AUDIT)
24.包装(PACKING)
